
10月31日,由艾邦智造主办的《2025年第二届半导体陶瓷产业论坛》在无锡成功举行。瀚思瑞受邀参会并发表主题报告《浅谈高可靠性氮化铝基板前景》,围绕功率模块的高热导、高可靠性需求,分享了氮化铝AMB基板在材料增韧、界面优化、结构设计及可靠性验证方面的最新研究成果。
以高可靠性引领功率模块新一代基板革新
随着新能源汽车、5G通信及功率电子产业的高速发展,模块的功率密度和封装集成度不断提升,对散热与可靠性提出了前所未有的挑战。传统氮化硅(Si₃N₄)陶瓷覆铜基板虽然具有良好的机械强度和热匹配性,但其热导率(约80–90 W/m·K)难以满足新一代功率芯片(GaN、SiC等)所需的高散热需求。
瀚思瑞团队深入研究氮化铝(AlN)基板的高热导优势与结构优化路径,在报告中分享了其在材料增韧、铜层应力释放设计、界面层优化及可靠性验证方面的最新成果。

技术创新:结构与材料双重突破
报告聚焦AlN材料在高热导与机械强度之间的平衡问题,提出了“高强度AlN瓷片 + 铜侧壁凹陷拓扑结构+界面层优化”的复合优化设计:
●高热导特性:AlN热导率是氮化硅的2–2.5倍,可大幅降低热阻,适配高功率密度模块;
●结构应力优化:在铜层边缘设计多阶凹陷结构,形成应力缓冲区,有效分散热应力集中;
●材料强化技术:通过定制粉体体系与两步烧结工艺,增强陶瓷Z轴向抗拉性能,显著提升AlN陶瓷的致密度与屈服强度;
●可靠性提升:新型基板TCT循环寿命达1000次以上,三点抗弯强度突破500MPa,实现了AlN基板在热导率与可靠性两方面的同步跃升;
●界面层优化:通过对焊料界面层优化,不但有效降低烧结气孔率,且进一步弱化因CTE差异产生的热棘轮效应,适合应用于温度极冷-极热转换的环境。
这一方案成功克服了传统AlN陶瓷“高热导但脆性大”的固有瓶颈,使产品在热循环耐性、抗热冲击性、抗机械冲击及力学抗弯强度等关键指标上全面对齐Si₃N₄基板。

验证成果:可靠性全面验证
瀚思瑞在报告中分享了针对新型AlN AMB基板开展了系统性验证测试,包括:
●TCT循环测试(-55℃~150℃):热循环寿命提升10倍以上,1000次循环后仍未失效;
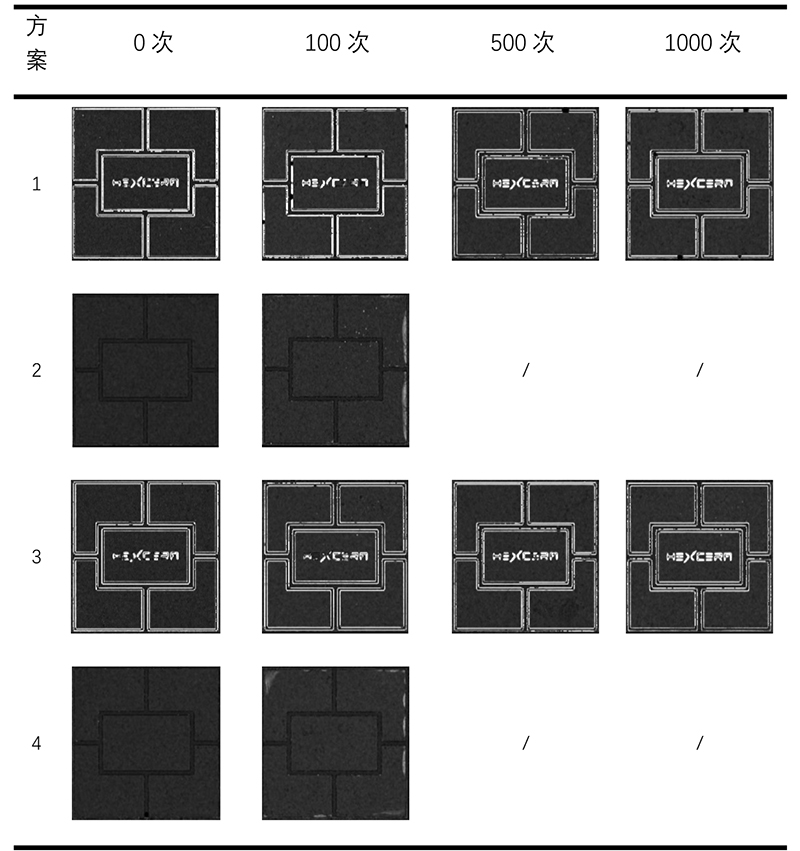
TCT循环测试C-SAM
●热震测试(340℃急冷水淬):边缘凹陷结构显著提升瞬时耐热冲击性能;
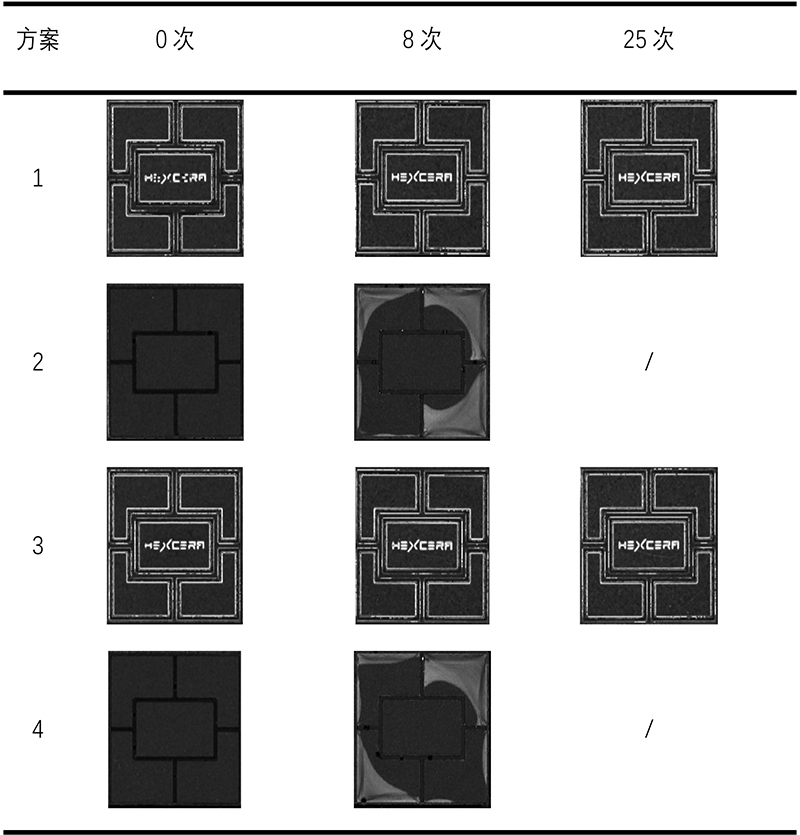
热震测试C-SAM
●抗弯强度与Weibull分析:陶瓷抗弯强度≥470MPa,Weibull形状参数β>10,强度分布均匀;

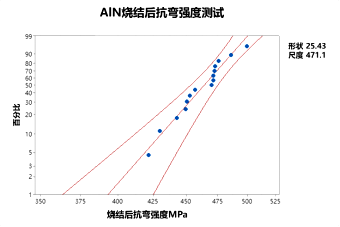
烧结前高强度AlN陶瓷抗弯强度Weibull图(上);烧结后高强度AlN陶瓷抗弯强度Weibull图(下)
●通炉对比测试:Reflow前后抗弯性能稳定,强度衰减小于1%。

通炉前后抗弯力对比
通过系统的实验验证与Weibull统计分析,瀚思瑞团队验证并讨论了边缘凹陷设计(Thermax系列)与高强度AlN瓷片结合的可行性,并在此设计基础上创新性的优化焊料界面层,实现了高可靠性技术方案迭代(Thermax pro),在应力分散、疲劳寿命与抗热冲击性能上均实现跨越式提升,为高功率模块、车载电驱系统、SiC/GaN封装等领域提供了可产业化的高可靠基板方案。
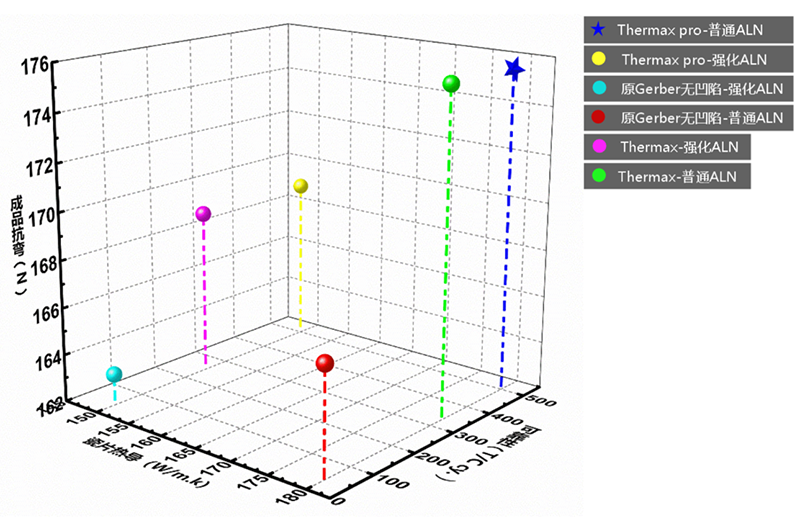
报告最后,瀚思瑞指出,面对功率模块不断提升的散热与可靠性需求,公司未来将基于功率半导体未来发展趋势,继续探索异形凹槽结构、优化整体结构及新型高导热陶瓷材料或其他复合材料的应用可能性,携手产业链上下游,推动AMB/DCB陶瓷覆铜基板向更高性能、更广应用的方向演进,共同助力我国半导体陶瓷产业的自主创新与高质量发展。